雷射輔助碳化矽晶圓快速拋光技術
摘要:本文說明雷射輔助碳化矽晶圓快速拋光技術。超快雷射誘發多光子分子鍵解離效應,碳化矽改質軟化後鍵結被破壞,分解成矽(Si)、碳(C)與非晶態碳化矽(Amorphous SiC)。改質軟化後碳化矽晶圓表面呈現柱狀週期性微結構,拋光過程的機械應力可輕易將此拋除。此法大幅降低碳化矽硬度90%以上,並可加速碳化矽晶圓之製程速率約30%,並大幅降低拋光之耗材消耗。
Abstract:This article describes the laser-assisted rapid polishing technology for silicon carbide wafers. The ultrafast laser induces a multi-photon molecular bond dissociation effect, to modify and soften the silicon carbide and destroy the bond, then decomposed into silicon (Si), carbon (C) and amorphous silicon carbide (Amorphous SiC). After the modification and softening, the surface of the silicon carbide wafer presents a columnar periodic microstructure, which can be easily removed by the mechanical stress of the polishing process. This method can greatly reduce the hardness of silicon carbide by more than 90%, accelerate the process rate of silicon carbide wafers by about 30%, and greatly reduce the consumption of polishing consumables.
關鍵詞:超快雷射、碳化矽、拋光
Keywords:Ultra-fast laser, Silicon carbide, Polishing
前言
由於碳化矽(SiC)具備高電壓耐受度、高速電子飽和移動、高導熱性等優勢,在綠能發電(需高壓)、電動車驅動(需高壓/散熱)如圖1 [1]等領域可節省能耗,如碳化矽直交流轉換器相較於矽基直交流轉換器減少約73%電力轉換損失[2],適合用於電動車之大功率DC/AC逆變器、DC/DC轉換器與AC/DC轉換器元件。受益於節能需求的急遽增加,Yole預估2022年全球碳化矽半導體產值可達10億美元[3],預估 2020-2022年CAGR: 40%極具發展潛力,許多國際半導體大廠如Infineon/Cree/ROHM已大力投入。

圖1 碳化矽元件在電動車之潛在應用
台灣為半導體產業大國,總體產值達3.22兆新台幣(工研院產科國際所數據),然而整體成動動能趨緩,急需新成長動力。因此化合物半導體領域吸引許多台灣廠商爭相投入,如台聚及環球晶投入寬能隙材料長晶技術開發。台積電、世界先進 提供GaN-on-Si的代工業務。穩懋發展 GaN-on-SiC 瞄準5G基地台應用,並提供寬能隙功率電子元件之晶圓代工。漢磊斥資3.4億元新建置6吋SiC生產線。晶圓製造(切割、研磨及拋光等)部分,雖有製造廠(環球晶、漢磊及太極等)及設備商(創技、世極、凱勒斯)投入,但使用傳統機械加工與國外進口設備並進方式,成本高、速度慢、製程技術仍落後國外。目前全球碳化矽晶圓材料短缺,價格昂貴(四吋碳化矽晶圓售價高達600美元以上),研磨拋光設備由日系大廠DISCO與SPEEDFAM壟斷,嚴重影響台灣產業鏈發展。
碳化矽硬度高研磨/拋光不易,研磨製程是利用砂輪進行研磨,砂輪使用壽命短、以400號砂輪為例,砂輪的耗損率為3 μm/min,砂輪可供磨耗厚度約8 mm,換算推得每顆砂輪僅能研磨44小時即須更換,因此研磨成本與時間增加、量產不易。拋光製程則是速率緩慢移除率僅有~6.9 nm/min,拋光一片碳化矽晶圓須8~16小時,成為大面積碳化矽晶圓製造瓶頸。解決方案之一可導入超快雷射改質軟化方法,藉由超快雷射的多光子分子鍵解離效應,將聚焦處之碳化矽半導體材料之鍵結鍵破壞,分解成矽(Si)、碳(C)與amorphous SiC的分離元素,大幅降低碳化矽硬度(降低90%以上),導入為碳化矽晶圓拋光製程之前工序,之後再進行碳化矽拋光便可大幅降低製程時間與耗材消耗。
本文說明雷射輔助碳化矽製造技術之國際開發進展與工研院雷射中心開發雷射輔助碳化矽拋光技術進展,利用工研院雷射中心所建立之碳化矽雷射改質系統進行實驗,並分析碳化矽經雷射改質軟化後之表面狀態。最後將改質軟化後之碳化矽晶圓實際用於拋光測試。
雷射輔助碳化矽製造技術國際開發進展
目前商用碳化矽晶圓片製造流程如圖2,先將長晶所得之晶柱切片與整形,再利用線鋸切割機切成晶片,再將晶片經粗研磨將晶片整平提高平整度(Total Thickness Variation, TTV)並降低粗糙度,再經精密研磨,表面粗糙度Ra降至3~5 nm以下,最後再透過化學機械拋光(Chemical-Mechanical Planarization, CMP),達到成品晶圓片規格TTV<3 μm,Ra<0.3 nm。
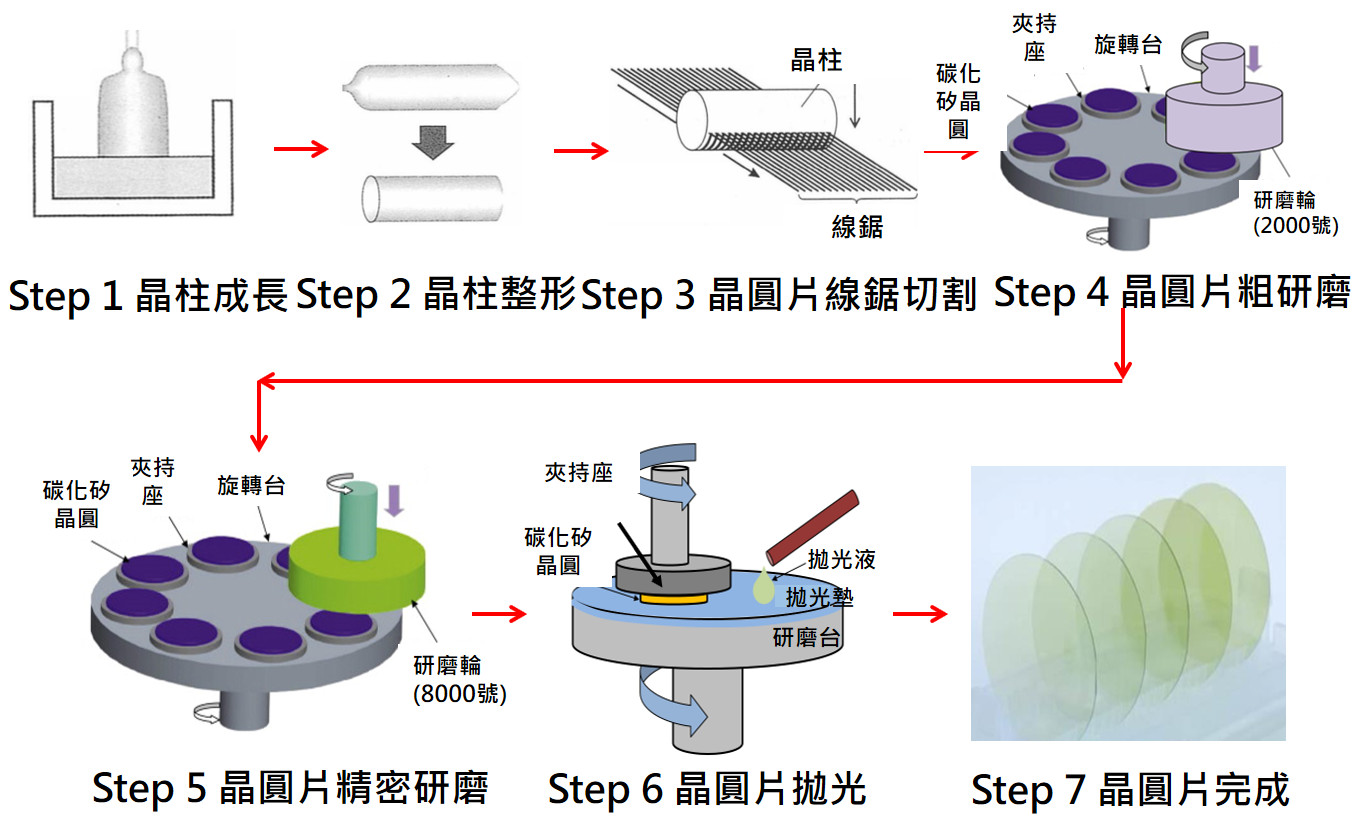
圖2 現行碳化矽晶圓製作流程
…本文未結束
更完整的內容 歡迎訂購 2022年2月號 467期
機械工業雜誌‧每期240元‧一年12期2400元
我要訂購