晶圓厚度及翹曲檢測技術發展
作者:
王浩偉、張奕威、Abraham Mario Tapilouw、張樂融
刊登日期:2023/06/02
摘要:隨著半導體尺寸微縮趨勢,晶圓厚度越來越薄,對表面的要求也越來越高。晶圓翹曲或厚度變化過大,將導致晶圓破裂和後續製程的偏差,非接觸精確量測和反饋總厚度變異thickness(TTV, Total Thickness Variation)、翹曲(Warp)、彎曲(Bow)資料,對製程良率至關重要。但不同的晶圓厚度範圍、晶圓表面粗度、線上檢測等要求,將對量測方法有所限制,本文將比較各量測方法的適用性,並就共焦方法的量測原理、架構、量測比對,及未來需求發展作進一步介紹。
Abstract:Along with the trend of in semiconductor fabrication to achieve smaller pattern dimension, wafer thickness is getting thinner while the requirements for wafer surface quality is stricter. The key factors are wafer warpage and thickness variation, the larger wafer warpage and thickness variation the lower quality of the end products and even could leads causes wafer to break. Thus, there is a demand for an accurate non-contact measurement system to measure wafer thickness variation (TTV) and wafer warpage to enable stricter monitoring of the quality of produced wafers. However, every measurement technique also has physical limitation and parameters that can be measured, e.g. thickness, surface roughness, measurement time, etc. This article briefly discusses different measurement techniques and their suitable application areas, and also introduces principles of developed chromatic confocal sensor-based wafer measurement system, calibration procedure, measurement data reconciliation, and also other challenges to be tackled for future developments.
關鍵詞:晶圓厚度、晶圓厚度變異、晶圓翹曲、彩色共焦
Keywords:Wafer Thickness, TTV, Wafer Warp, Chromatic Confocal
前言
目前晶圓翹曲檢測方法,可分干涉式、電容式、共焦以及光偏轉法四類(Interferometer [1~6], Capacity, Chromatic Confocal,and Optical Deflectometry) [7~12]。Corning Tropel的FlatMaster採用可變波長雷射進行干涉量測,量測精度可達奈米等級,但價格昂貴多用於實驗室。MTI 的Proforma 300則是利用電容感測原理量測,雖然價格便宜,但由於感測探頭無法有效縮小,水平解析度差,加上探頭面積會將端點的高度值平均掉,影響真實高度值,應用受限。故實際使用到產線的方法,多為光偏折法及共焦法。
光偏折法藉樣品表面斜率進入量測,如相位量測法(Phase Measuring Deflectometry)[2-9]或條紋反射法(Fringe Reflection Method),將相位移條紋影像投影於晶圓上方,以相機擷取經由晶圓反射的條紋影像,並用相位移及相位展開演算法計算出條紋偏移量及晶圓表面斜率變化,進而得到全域晶圓形貌及曲率半徑。此方法優勢在於量測速度快,每片晶圓全域量測可於5秒內完成且量測過程中沒有任何移動件。
但晶圓表面可能為單拋、雙拋,表面的粗糙不規則性,如圖1所示,不利於光偏轉法檢測。故在樣品複雜性條件下,只有共焦方式適合應用於各種晶圓的厚度與翹曲量測,如FRT之MicroProf 200 ,及工研院的共焦系統,本文將詳述利用光色散法在晶圓形貌的應用。

圖1 共焦探頭設計
量測原理及系統架構
藉由色散物鏡不同波長光可聚焦在不同深度,量測過程中隨著物體高度不同,不同z位置將反射不同波長的光。如後端加入光譜儀監視波長變化,可得到對應的不同高度Z,所以探頭及樣品不需進行Z軸移動,即可高速進行量測。此多波長共焦物鏡以多組複合鏡片群特殊設計,使同時具備大色散景深且大NA(Numerical Aperture) 收光的光學效果,架構如圖1所示。透過提升多波長共焦物鏡的NA數值,加大收光角度來接受因粗糙表面而漫射的光訊號,藉此方式來突破不同表面的限制,有效提升量測精度與量測速度。
為了同時量測單拋及雙拋晶圓的翹曲與厚度,兩個共焦探頭須以同光軸架構量測正背面,如圖2,使上下模組量測到樣品的相同位置。利用雙模組的相對距離減去各自量測距離晶圓表面的距離,可計算出晶圓本體的厚度值資訊。再結合自動化XY平移台,如圖3,可進行大區域範圍量測,完整量測出12"矽晶圓的各區域總厚度變異(TTV, Total Thickness Variation)、翹曲 (Warp)、彎曲(Bow)等數值。掃描路徑依使用者需求,彈性設定為米字型或之字型,如圖4所示。
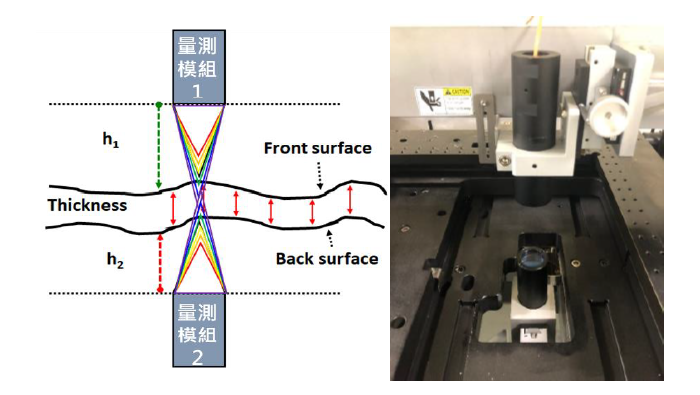
圖2 矽晶圓的翹曲與厚度量測架構示意

圖3 矽晶圓量測機台架構

圖4 量測路徑規劃
系統演算與校正
系統演算及校正分為單獨探頭的Z量測值校正、Z解析度量測、與厚度量測校正三大部分。首先以已知波長的光源引入系統,校正出圖2光譜儀PIXEL與光強度的對應,再進行Z量測值校正。我們放置平面鏡於樣品位置,透過移動平面鏡,可得到不同Z與反射光譜訊號波長的對應曲線,及Z量測範圍,如圖5所示。圖5右方曲線,會以查找表(lookup table)形式儲存在系統中,以便從光譜量測結果直接算出Z值來進行應用。選定特定Z條件上下移動探頭,可掃描得到對應波段的光譜帶寬,如圖6,定義出該波段的光譜解析度或Z解析度。兩探頭完成校正後,系統開始透過針孔(pinhole)治具,進行共光軸校正,藉兩側光強極大值,來調整雙探頭XY偏位,如圖7所示。

圖5 Z高度與波長的線性關係

圖6 Z解析度量測

圖7 pinhole治具外觀
…本文未結束
更完整的內容 歡迎訂購 2023年6月號 483期
機械工業雜誌‧每期240元‧一年12期2400元
我要訂購