氦離子束檢測技術簡介及其於高深寬比結構鍍膜製程研發之應用
作者:
李建霖、王亘黼、蔡坤諭、錢盛偉、蔡佳勳、董福慶、王慶鈞
刊登日期:2021/05/28
摘要:目前的掃描電子顯微鏡技術存在著一些性能上的限制。在奈米等級結構上,影像解析度通常受限於樣品相互作用的體積,而不是實際的聚焦點大小。使用較高能量電子束或較大質量的粒子束源雖然可以減少散射的影響,但隨之而來的副作用,如更大的樣品相互作用體積及大量分散的粒子源能量使影像解析度仍舊無法提升。近年來,氣體場離子源研究的進展使得以輕惰性氣體離子作為離子源的顯微設備得以實現,有助於奈米等級結構的檢測及相關製程研發。本文將針對氦離子束檢測技術及高深寬比結構鍍膜技術進行介紹。
Abstract:Current scanning electron microscopy technology suffers from several performance limitations. The image resolution is usually limited by the volume of the sample interaction rather than the actual spot size on nanoscale structures. While the use of higher energy electron beams or larger mass particle beam sources can reduce the effect of scattering, the accompanying side effects of larger sample interaction volumes and the large energy spread still prevent image resolution from being improved. In recent years, advances in gas field ion source research have enabled the realization of microscopy devices using light inert gas ions as the ion source, which helps the detection of nanoscale structures and related process development. In this article, we will introduce the helium ion beam inspection technique and the high aspect ratio structures deposition techniques.
關鍵詞:氦離子束顯微術、高深寬比結構、鍍膜
Keywords:Helium ion microscopy, High aspect ratio structures, Deposition
前言
封裝成膜技術於光電半導體產業中屬關鍵製程,尤其在後疫情時代之製造業「去全球化」,更凸顯自主生產半導體製程設備的重要性。工業技術研究院機械所專利化「複合多重模態薄膜沉積設備」(以下簡稱雙模態),結合原子層化學氣相沉積技術(Atomic Layer Deposition, ALD)以及電漿輔助化學氣相沉積技術(Plasma-Enhanced Chemical Vapor Deposition, PECVD)於共同腔體,達到多種設備整合之目的,減少試片樣品於不同腔體轉換的移動時間,並減少移出沉積腔體後可能的污染。雙模態設備最大特點為低溫封裝(< 80 ℃),且能在單一試片鍍膜製程中切換ALD與PECVD沉積方式,無須移動樣品或是更換設備腔體,適合應用於光電元件阻隔水氣封裝、阻障層(Barrier layer)、以及3D-IC和階梯結構的覆蓋。
當半導體製程完成後,為了檢視及分析製程好壞,通常需要透過檢測設備對樣品進行取樣。掃描式電子顯微鏡(Scanning Electron Microscope, SEM)為常見的一種檢測設備,其好處為能以相當高的解析度獲取樣品的表面結構、形狀等資訊。然而在奈米等級結構的應用上,SEM的解析度及對比等性能會受到限制,儘管SEM的電子束聚焦點為奈米等級,但影像解析度往往受到電子與樣品的交互作用體積影響而大於實際聚焦點大小;另外電子束聚焦點大小也和其散射及色差有負相關,雖然能夠過提高電子束能量或更換較大質量的粒子源,如聚焦鎵離子束(Focused ion beam, FIB)用以降低散射等效應,但前者因更大的作用體積而降低解析度,後者由於液態金屬離子源(Liquid Metal Ion Source, LMIS)的能量較為分散使色差表現不佳,加上鎵( Gallium )離子束容易對樣品產生破壞及永久的離子佈植,因此都不是合適的替代技術。直到近十幾年,在氣態場離子源(Gas Field Ion Source, GFIS)技術上有所突破[1],使得高亮度 ( B > 4 × 109 A/cm2 sr)、低散射(λ~80 fm)及低能量發散(ΔE/E ~ 2 × 10-5)的輕惰性氣體離子源得以實現,如氦離子、氖離子等,進而產生可以兼顧高影像解析度及低樣品破壞的檢測設備,氦離子束顯微鏡(Helium Ion Microscope, HIM)與傳統SEM對比如圖1。除了用於樣品檢測,氦離子束亦可用於奈米結構的直寫製作,例如基於傳統光阻製程的氦離子束直寫微影[2-4],其透過次奈米等級的解析度加上較小的鄰近效應[5,6],相當適合用於數十奈米結構的製造;而透過類似濺鍍機制的氦離子束直接銑削甚至可用於製作次十奈米尺寸的結構[8-10],雖然其製造時間較光阻微影機制要長許多,但其相當適合作為前瞻元件及結構的原型開發應用上。綜合以上機制,HIM系統成為極高解析度樣品表面影像擷取和奈米製造的理想設備之一。
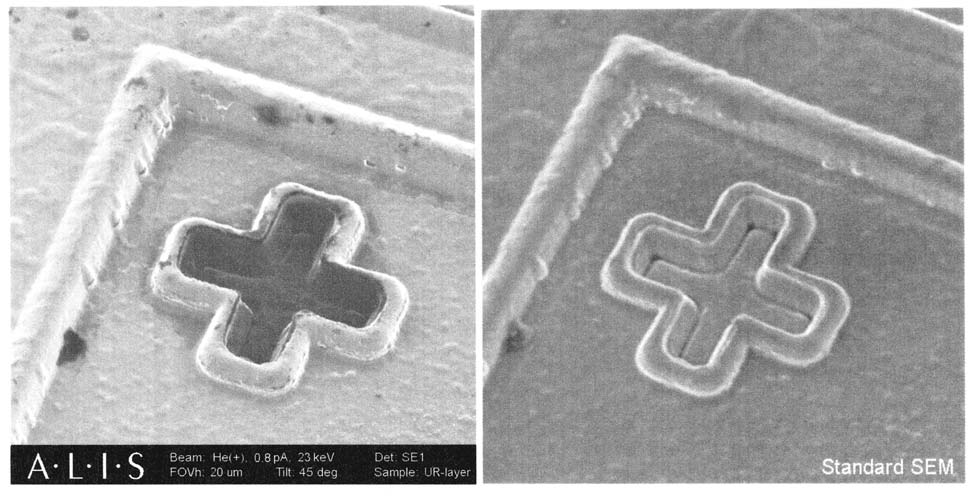
圖1 氦離子束影像(左)與傳統SEM影像(右)對比圖,圖中可見氦離子束影像在不同材料的分辨度較傳統SEM佳[1]
雙模態設備及氦離子束檢測技術簡介
(一)雙模態設備簡介
雙模態設備須兼容ALD氣流場和PECVD之電漿作用空間,於機構設計上具有良好調節性質。ALD鍍膜系統模組包含真空腔體與機架,其中真空腔體內之噴灑頭(Showerhead),供ALD製程與PECVD製程氣體供應,另外內含基板承載與加熱模組以及下電極偏壓模組,雙模態於ALD鍍膜之專利設備示意圖如圖2。

圖2 雙模態ALD鍍膜製程示意圖
…本文未結束
更完整的內容 歡迎訂購 2021年6月號 459期
機械工業雜誌‧每期240元‧一年12期2400元
我要訂購