應用於先進半導體封裝的薄型化TGV天線製造技術
摘要:本文結合工研院機械所與資通所的技術,合作設計開發出了一種新穎的製程整合技術,並用於低損耗的28 GHz毫米波相控陣列玻璃天線的研製。本文選用具有TGV結構的薄型化玻璃基板,使其有潛力被應用在2.5D / 3D半導體異質整合製造技術中。結果證實我們成功研製出操作頻寬涵蓋27.8 GHz到28.9 GHz頻段約1.1 GHz (2:1 VSWR 定義)的5G毫米波天線陣列,其天線效率和峰值天線增益分別高於70%和10 dBi。我們成功產生具有指向性以及扇形覆蓋的3D遠場輻射場型,其在y-z平面上的3-dB輻射波束寬度約為80度,在x-z平面上約為30度。因此,本文開發之技術具有極高的可行性並可應用於薄型化5G毫米波相位陣列天線的研製。
Abstract:In this article, combining the technologies of MMSL/ITRI and ICL/ITRI, we developed a novel approach for fabricating a mmWave phased array antenna on a selected low-loss glass substrate with a single (TGV) structure for 28 GHz 5G mmWave wireless communication applications. Because the thin-type TGV substrate is selected, which has the potential to be applied in 2.5D / 3D semiconductor heterogeneous integration manufacturing technology. The results show that the operating bandwidth covers 27.8 GHz to 28.9 GHz frequency band of about 1.1 GHz. (2:1 VSWR definition) 5G millimeter-wave antenna array. The antenna efficiency and realized peak antenna gain are higher than 70% and 10 dBi, respectively. We successfully generated a 3D far-field radiation pattern with directivity and sector coverage, with a 3-dB radiation beam width of about 80 degrees in the y-z plane and about 30 degrees in the x-z plane. Therefore, the novel manufacturing technologies in this article has high feasibility and can be applied to the development of thin-type 5G millimeter-wave phased array antennas.
關鍵詞:5G高頻陣列天線、玻璃通孔(TGV)、先進半導體封裝
Keywords : 5G mmWave antenna, Through Glass Via (TGV), Advanced Semiconductor Packaging
前言
近年來,5G通信、雲端計算、人工智能與物聯網等新技術的發展加速,提升了人類對於電子產品的計算能力、傳輸速率和傳輸帶寬的需求。毫米波通訊由於具有高容量、高傳輸速率和豐富的頻譜資源等優勢,成為高頻天線與通訊發展的重要基石。但隨著通訊傳輸頻率的增加,在毫米波頻段的高頻天線對於材料性能和物理定律的限制也不斷地提升。例如:表面粗糙度(surface roughness)、集膚效應(skin effect)等,最終導致在晶片訊號中電阻-電容延遲時間(RC delay)超過了閘延遲(gate delay)的時間,因此在高頻天線封裝的領域中,如何降低訊號損耗的問題顯得越來越重要。
隨著頻率的提升,天線與射頻晶片的分離封裝面臨內接金屬互連損耗過大與低密度無法提高的挑戰,導致整體通訊系統性能下降,難以滿足未來通信大規模系統整合的需求。所以,天線與射頻前端共同設計、共同封裝的方式,例如:天線整合晶片(Antenna on Chip, AoC)、封裝天線技術(Antenna in Packaging, AiP)或其他混合的方式,都被廣泛認為是一種在毫米波以上波段進行通訊的可行的系統解決方案之一[1]。相較於天線整合晶片而言,封裝天線技術在製程難度、天線性能和成本之間具有相對的可匹配性,且可以通過異構整合(hydrogenous integration)的方式巧妙地整合到無線系統中。因為封裝天線技術利用3D封裝技術,大幅縮短導線路徑,使電阻-電容延遲時間縮短,同時提高系統電源效率。所以封裝天線技術目前廣泛應用於5G通信、雷達、成像、探測等毫米波的應用。
毫米波的天線封裝研發的趨勢大致可分為兩種,一種以天線堆疊(stack)於垂直導線(vertical interconnection)進行封裝,由於大幅縮短了導線長度,所以大幅降低了傳輸損耗與天線封裝尺寸。而另一種是改變選用較低的介電損耗的封裝基板材料,如玻璃(glass)來替代現有的陶瓷、高分子和矽。以玻璃為例,因其絕緣、超薄、高機械強度、高穩定性和可調節熱膨脹係數等優點而成為高頻基板中最有前途的候選材料之一。另外,玻璃基板除了在毫米波段訊號傳遞中的電磁特性遠優於矽,可實現超低介電損耗。與現今廣泛應用的高分子基板材料相比,玻璃還可以實現應用在更精細的電路設計,同時更具有較低的損耗、超薄與穩定性。而且,玻璃基板還有利於大尺寸面板級的封裝,且無須沉積絕緣層的優勢,同時又降低製造成本。所以利用玻璃通孔(Through Glass Via, TGV)基板進行毫米波天線的應用成為各方廠商與研究單位矚目的產業研究焦點。
儘管玻璃基板具有上述突出的優點和好處,但仍然存在相關的製程模組與整合技術上的挑戰,例如本文所採用的玻璃基板很薄(350 μm),因此無法利用傳統IC載板所使用的乾膜法(dry film)進行圖案化的黃光製程(lithography)。因此本文創新開發出特殊的光阻填充法(photoresist fill method)進行TGV側壁保護等一系列的製程方法來完成玻璃基板毫米波天線陣列的研製。本文針對28 GHz毫米波1x4 串聯陣列天線進行前期可行性評估研究,透過HPSS軟體進行天線設計與模擬,搭配創新製程整合技術實現製作出應用於5G通訊的毫米波天線,最終透過實際的訊號量測,證明模擬設計與製造技術用於5G相位陣列天線的可行性。
TGV玻璃金屬化技術
近年由於高階IC載板(IC substrate)以及先進半導體系統級封裝(System in Packaging, SiP)對於材料特性的需求,國際研發單位與廠商紛紛積極投入”以玻璃為基板材料,用來取代傳統的IC載板”的相關研發工作。因此,玻璃金屬化技術(glass metallization)已成為關鍵性的基礎製程技術。目前玻璃金屬化技術可大致分為乾式金屬沉積製程(dry metal deposition process)與濕式金屬沉積製程(wet metal deposition process)。以乾式金屬沉積製程為例,多數是以陰極濺射式的物理氣相沉積(Cathode Arc Physical Vapor Deposition, Arc-PVD)的方式[2],透過高能粒子轟擊固體靶材的表面,將靶材汽化(vaporization)後濺鍍到待鍍物表面。然而,Arc-PVD的鍍膜階梯覆蓋率(step coverage)過低,僅不到五成,再加上析鍍速率相當慢,導致除了薄膜的成本較高之外,更容易形成不連續的晶種層或TGV側壁晶種層附著力差的問題,因此濕式玻璃金屬化成為眾人關注的焦點。
目前濕式金屬化技術大致可分為五個不同團隊[3-9],如表1所示。多數的團隊都需要在導線材料(銅)和玻璃基板中間,增加一層當作附著層(adhesion promoting layer)。不約而同的是,多數團隊都以金屬氧化物(metal oxide thin-film)作為附著層材料。雖然各自選擇的材料種類不同,但製程原理大致相同,基本上均以溶膠凝膠法(sol-gel method),將附著層材料以濕式塗佈技術(包含:浸漬塗佈、旋轉塗佈、噴塗等)塗佈到玻璃基材表面上。再經過高溫燒結(sintering)的方式,將此附著層固化沉積在玻璃基材的表面上。然後以無電鍍(electroless)的方式沉積金屬晶種層,最終以電鍍(electroplating)的方式進行導線的製作。但目前尚未有研究,針對金屬氧化物薄膜是否會對於高頻訊號傳遞產生影響。因此,為確保研究的單純性,本文還是利用雙面Arc-PVD進行金屬沈積,並在Arc-PVD中加入外磁鐵,透過磁場控制來增加物理氣相沉積製程的準直性,進而達成高深寬比玻璃金屬化的目標。
.png)
表1 目前濕式玻璃金屬化技術比較表[3-9]
薄型化TGV毫米波相位陣列天線製程設計
在具有TGV結構的薄玻璃基板上製造高頻天線,需要解決許多製程上的挑戰,例如:薄型化TGV玻璃基板容易破損、雙面TGV玻璃金屬化、電鍍銅均勻性、雙面圖案化、TGV側壁銅薄膜保護製程、濕蝕刻製程的微負載效應(micro-loading effect)以及天線圖案的尺寸的製程變異等相關製程與整合的問題都需要克服。為此,本文創新開發出特殊的光阻填充法,利用正負光阻的材料特性來降低超薄TGV玻璃基板於雙面圖案化、TGV側壁銅膜保護製程等製程難關,成功將1x4線性相位陣列式的高頻天線製作於具高深寬比通孔的玻璃基板上,用以進行28 GHz mmWave 巨量多輸入多輸出天線( Massive MIMO array antenna)的先期研究[10-12]。
在本文中所使用的TGV玻璃基板尺寸為10.0 cm × 10.0 cm方形玻璃基板,其厚度約為350 μm,TGV直徑約為200 μm。首先,將玻璃基板進行2次清洗製程,其細節如表2所示。TGV基板清洗後,先將玻璃基板通過雙面的Arc-PVD Ti/Cu 濺射氣相沉積製程。再以本文所開發的電鍍製程將Cu薄膜厚度增加到約6 μm。然後先使用SU-8(Microchem Corporation)負型光阻進行雙面黃光微影製程對樣品進行圖案化的定義。為了防止濕蝕刻溶液損壞TGV側壁上的Cu薄膜,我們利用本文所開發出的特殊光阻填充法,將正型光阻(FH-6400 UJIFILM Arch,日本)填充進TGV中作為側壁銅薄膜及天線背面的保護。其中正型光阻(FH-6400)會使用特殊設計的注射系統,將光阻從背面注入TGV之中,並均勻旋塗於樣品的背面。後續,玻璃基板的正面(天線面)會經過Cu/Ti的濕刻蝕製程,去除未被光阻保護的Ti/Cu雙層。接續以丙酮溶劑將正型光阻(FH-6400)去除後,重複上述相同的製程以完成背面的圖案化製作。最後,使用NMP(NMethyl-2-pyrrolidone)溶劑去除負型光阻(SU-8)並完成天線的製作,詳細的製程流程示意,如圖1所示。
.png)
表2 TGV玻璃基板清洗條件表
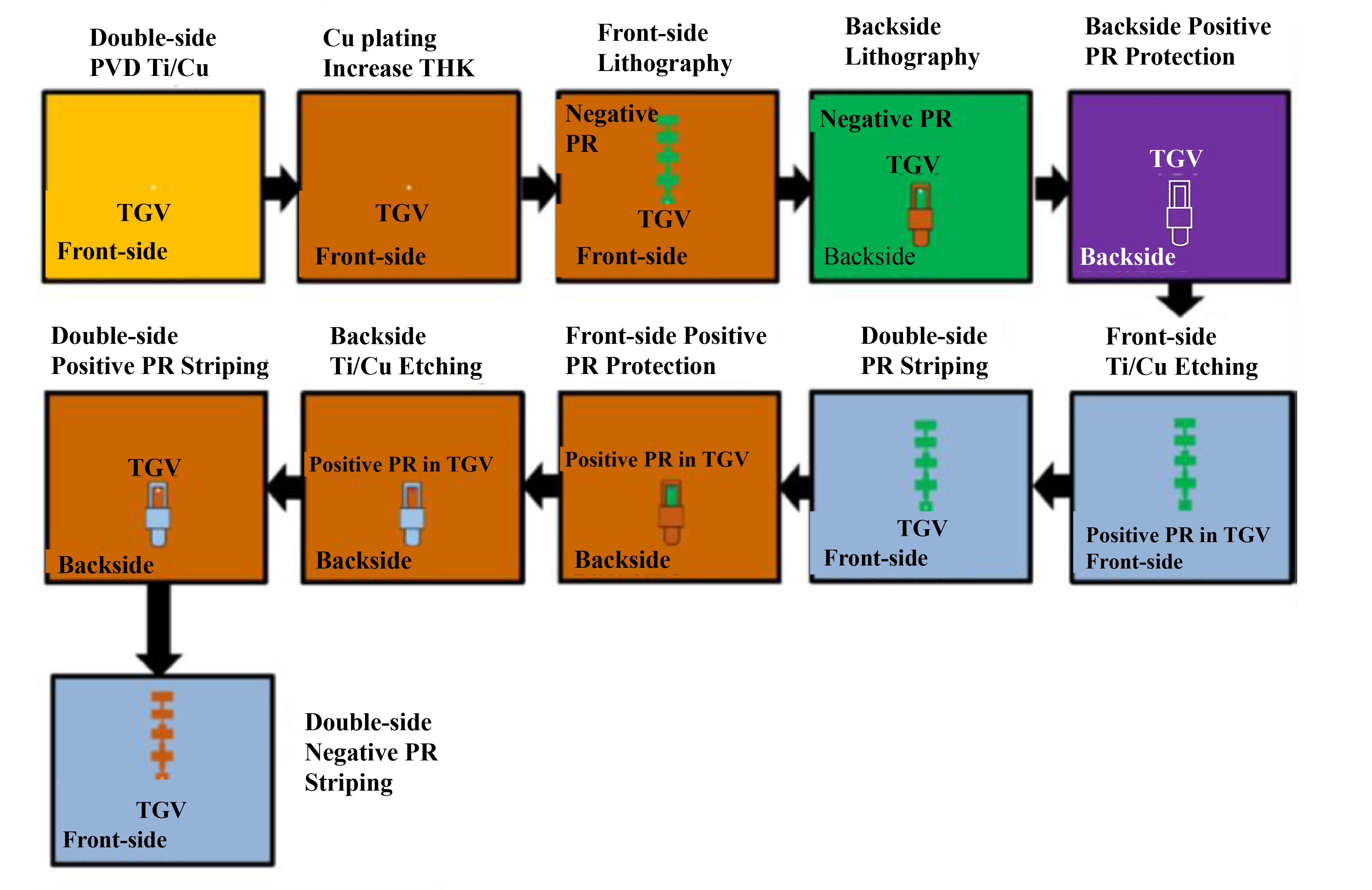
圖1 28 GHz毫米波TGV天線製程流程示意圖
…本文未結束
更完整的內容 歡迎訂購 2023年6月號 483期
機械工業雜誌‧每期240元‧一年12期2400元
我要訂購